





来源:中国半导体照明网|
发表时间:2018-09-06
点击:13690
文章来源:材料深一度
氧化镓(β-Ga2O3)单晶是一种直接带隙超宽禁带氧化物半导体,其禁带宽度为4.8~4.9eV,具有独特的紫外透过特性(吸收截止边~260nm);击穿电场强度高达8MV/cm,是Si的近27倍、SiC及GaN的2倍以上,巴利加优值分别是SiC、GaN的10倍、4倍以上,并且可以采用熔体法生长大尺寸体单晶,因此β-Ga2O3已成为超高压功率器件和深紫外光电子器件的优选材料之一。
纽约州立大学布法罗分校(University at Buffalo) 宣布研制出击穿电压超过1800V的β-Ga2O3 MOSFET [Ke Zeng et al, IEEE ElectronDevice Letters, published online 23 July 2018],而在此之前的耐压水平位于750V以下。击穿电压的提高归因于场板设计的改进,采用复合电介质支撑场板金属。在预期的高场区域采用原子层沉积( ALD )方法沉积电介质从而提高了材料质量。
该器件是使用半绝缘掺铁Ga2O3衬底制造的,在该衬底上先后沉积200nm厚的非故意掺杂(unintentionally doped ,UID )和掺锡( Sn )Ga2O3外延层。然后在源极/漏极区域使用旋涂玻璃技术选择性的进行Sn掺杂。源极/漏极的接触金属是退火的钛/金。栅极电介质是用ALD方法沉积的20nm厚的二氧化硅薄膜。等离子体增强化学气相沉积( PECVD )和ALD方法沉积的二氧化硅为场板结构提供了支持。该叠层还包括薄的ALD方法沉积的氧化铝层,该层被设计成用作栅极沟槽反应离子蚀刻的停止层。沟槽底部的氧化铝蚀刻停止层通过湿法蚀刻去除。栅极和场板金属由钛/铝/镍/金组成。
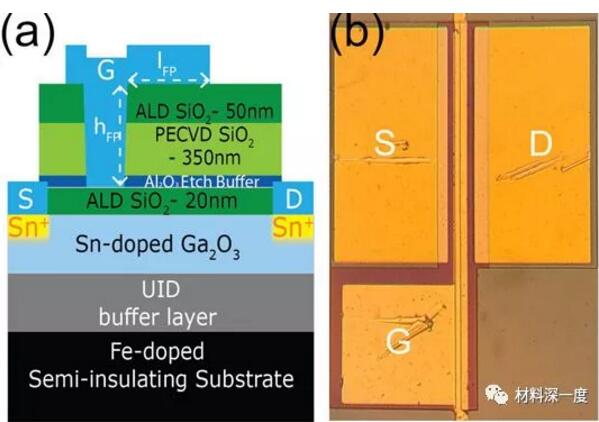
图 1 β-Ga2O3 MOSFET截面示意图以及光学显微镜下的结构图像
在电子氟化液(Fluorinert)环境中,该器件的击穿电压达到1850V,此时的栅-漏距离为20μm。其他因素保持不变,在空气环境下,该器件的击穿电压只有440V。通过改变栅-漏距离,研究人员发现在Fluorinert环境中下器件的击穿电压均为空气环境下的4倍左右。

图2 各材料体系电压与导通电阻的关系(直线为理论值、符号为氧化镓实验值)
“本文由新材料在线®平台入驻媒体号中国半导体照明网提供,观点仅代表作者本人,不代表本网站及新材料在线®立场,本站不对文章内容真实性、准确性等负责,尤其不对文中产品有关功能性、效果等提供担保。本站提醒读者,文章仅供学习参考,不构成任何投资及应用建议。如需转载,请联系原作者。如涉及作品内容、版权和其它问题,请与我们联系,我们将在第一时间处理!本站拥有对此声明的最终解释权。”

